
PhySim Electronic Technology Co., Ltd.

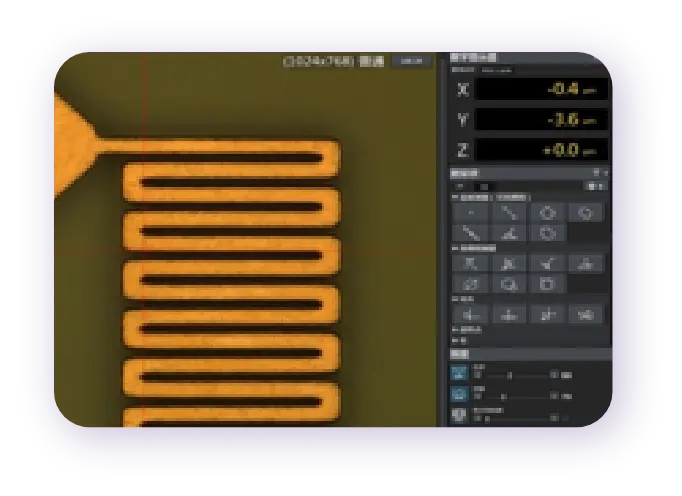

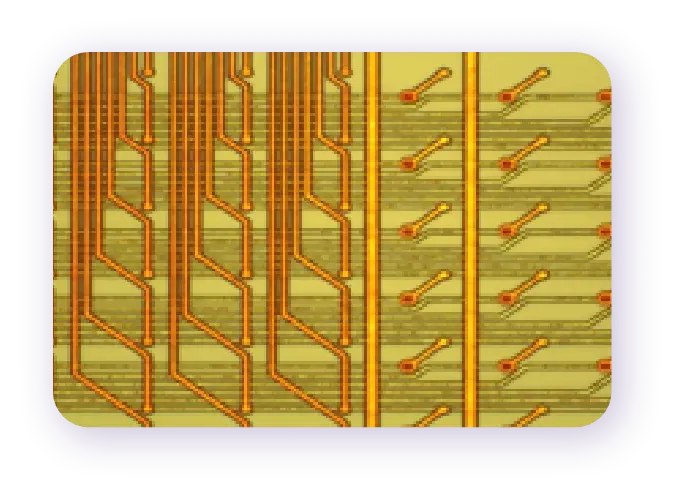
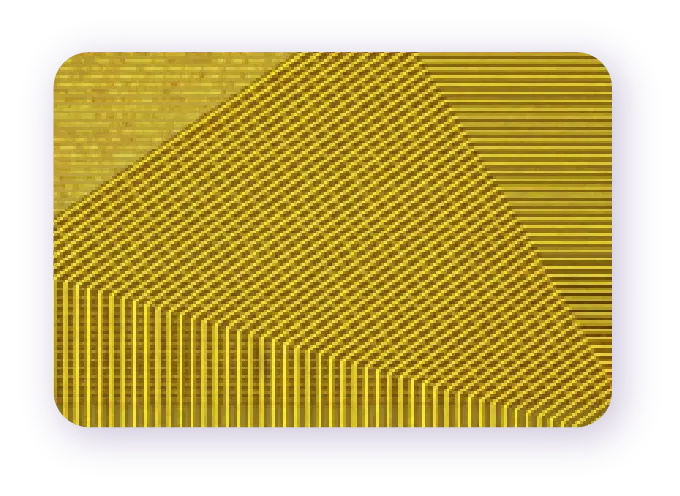
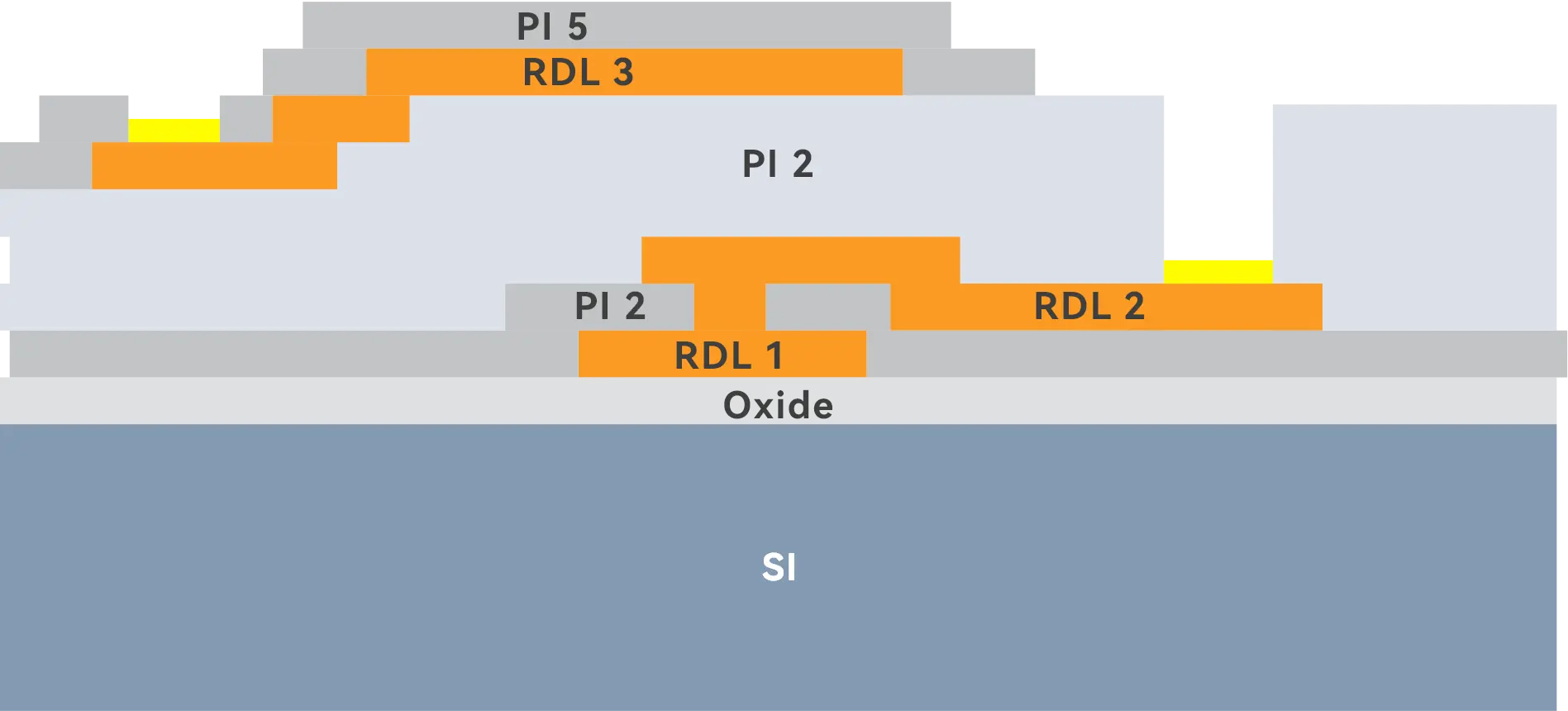
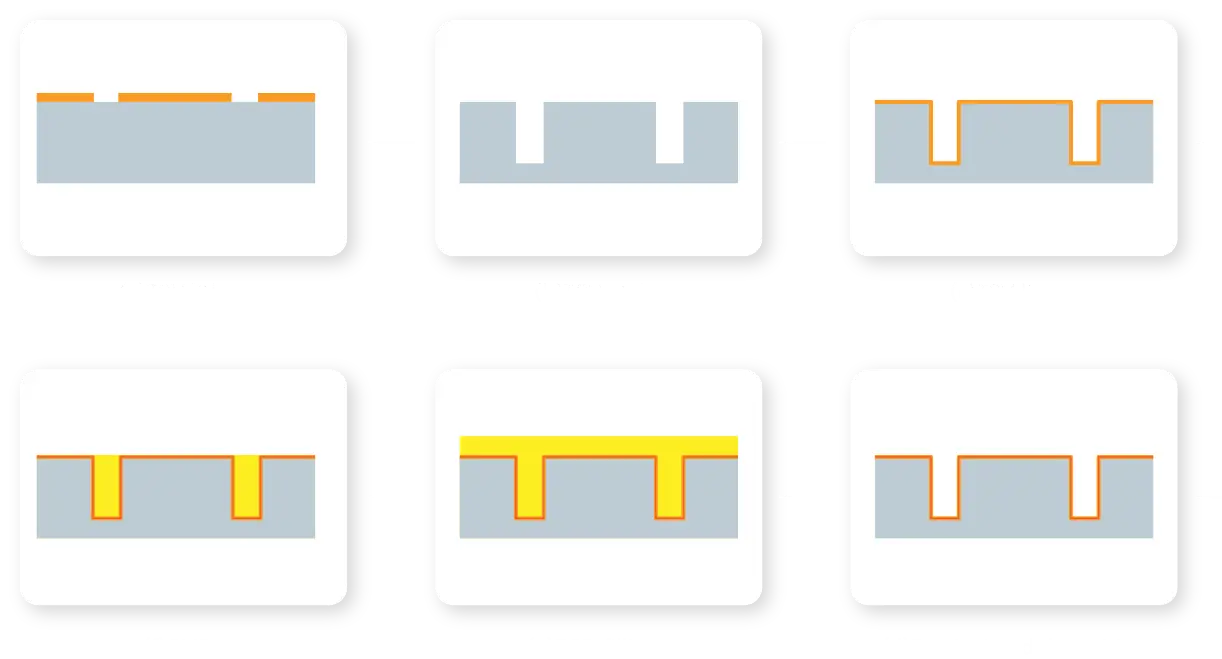
常规FC Bumping深圳中科实现最小间距80um量产;
Micro Bumping实现40um量产,开发完成25um间距。
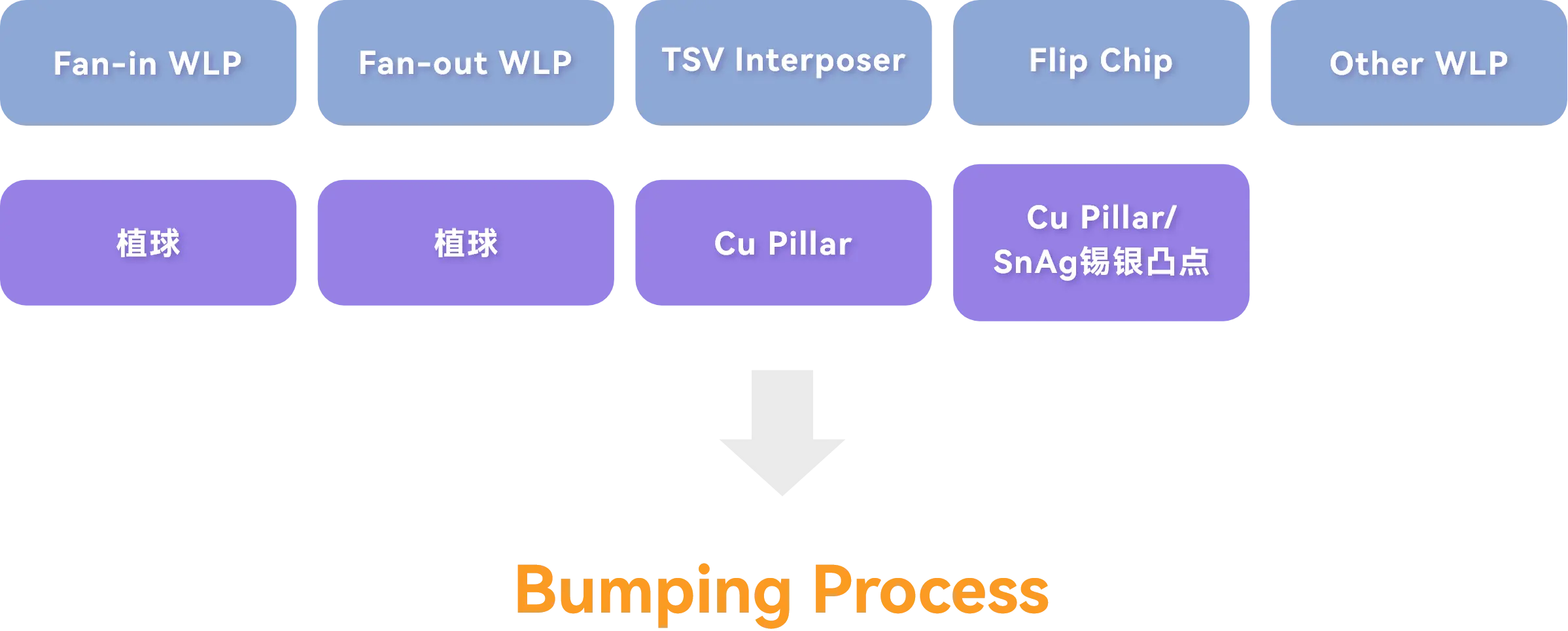
|
晶圆级封装
Wafer Level Package
|
||||
|---|---|---|---|---|
|
凸块
Bumping
|
扇入型晶圆级封装
Fan-In WLP
|
扇出型晶圆级封装
Fan-Out WLP
|
硅转接板
TSV Interposer
|
直孔晶圆级封装
Via Last TSV WLP
|
|
8”/12”
Cu Pillar
|
8”/12”
1P1M
|
12”
|
MAX
10:100 TSV
Interposer
|
12”
CIS TSV WLP
|
|
8”/12”
Sn-Ag
|
8”/12”
2P2M
|
8”
MEMS TSV WLP
|
||
|
12” Au
(Planning)
|
12”
FI TSV WLP
|
|||
|
12”
u-Bump
|
||||
| SiP封装设计/基板设计/电、热、应力仿真 | ||||
| 失效分析试验室 | ||||
| 可靠性分析实验室 | ||||